Cómo reducir las pérdidas, mejorar la eficiencia y ampliar el rango de temperatura en aplicaciones de alta potencia
Colaboración de Editores de DigiKey de América del Norte
2023-09-08
Los diseñadores de aplicaciones que consumen mucha energía necesitan convertidores de potencia más pequeños, ligeros y eficientes, capaces de funcionar a voltajes y temperaturas más elevados. Esto es especialmente cierto en aplicaciones como los vehículos eléctricos, donde estas mejoras se traducen en una carga más rápida y una mayor autonomía. Para lograr estas mejoras, los diseñadores utilizan convertidores de potencia basados en tecnologías de banda prohibida ancha (WBG) como el carburo de silicio (SiC).
Comparados con los de silicio (Si), estos dispositivos funcionan a voltajes más altos y pesan menos, pero tienen una capacidad de gestión de la energía similar. También funcionan a temperaturas más altas, lo que reduce las necesidades del sistema de refrigeración. Los dispositivos de SiC pueden funcionar a una frecuencia de conmutación más alta, lo que permite utilizar componentes pasivos más pequeños que reducen el tamaño y el peso del convertidor. Aun así, el SiC está en constante desarrollo, y los esfuerzos más recientes se traducen en una menor resistencia "on", lo que reduce aún más las pérdidas de potencia.
Este artículo analiza brevemente las ventajas del Sistema en chip (SiC) frente al Si, utilizando los VE como contexto. A continuación se analizan los avances en SiC antes de presentar la 4ª generación de MOSFET de SiC de ROHM Semiconductor, y se ilustra cómo ayudan a los diseñadores a reducir las pérdidas de potencia, el coste y la huella.
¿Por qué utilizar SiC?
Los vehículos eléctricos necesitan una batería de mayor capacidad y autonomía. Junto con esta tendencia, los voltajes de las baterías están aumentando hasta los 800 voltios para reducir el tiempo de carga. Por eso, los diseñadores de vehículos eléctricos necesitan dispositivos capaces de soportar estos voltajes más altos y, al mismo tiempo, reducir las pérdidas eléctricas y el peso. Los MOSFET de SiC de 4ª generación de ROHM Semiconductor ofrecen menores pérdidas gracias a una mayor tolerancia al voltaje, menores pérdidas de conducción y conmutación y tamaños más reducidos.
SiC, un semiconductor WBG, ofrece una eficiencia excepcional en aplicaciones de conmutación de potencia de alto voltaje en relación con la tecnología Si MOSFET. Una comparación de las propiedades físicas del SiC y el Si muestra el origen de esta mejora basada en cinco propiedades físicas: campo eléctrico de ruptura, banda prohibida, conductividad térmica y punto de fusión (Figura 1).
 Figura 1: Ventajas de los MOSFET de SiC frente a los de Si basadas en cinco propiedades físicas. (Fuente de la imagen: ROHM Semiconductors)
Figura 1: Ventajas de los MOSFET de SiC frente a los de Si basadas en cinco propiedades físicas. (Fuente de la imagen: ROHM Semiconductors)
La intensidad del campo eléctrico de ruptura del SiC es diez veces superior a la del Si, lo que permite diseñar dispositivos con voltajes de ruptura más elevados al tiempo que se reduce el grosor del dispositivo. La mayor banda prohibida del SiC permite que el dispositivo funcione a temperaturas mucho más elevadas. La mayor conductividad térmica reduce el esfuerzo necesario para enfriar el dispositivo, mientras que el mayor punto de fusión aumenta el rango de temperatura de funcionamiento. Por último, la mayor velocidad de deriva de electrones saturados del SiC se traduce en mayores frecuencias de conmutación posibles y menores pérdidas por conmutación. Estas frecuencias de conmutación más altas requieren filtros y otros componentes pasivos más pequeños, lo que reduce aún más el tamaño y el peso.
Desarrollo de MOSFET
Los MOSFET de SiC originales utilizaban una estructura plana en la que la puerta y el canal del dispositivo se encuentran en la superficie del semiconductor. La densidad de los componentes de los dispositivos planares es limitada, ya que no se puede reducir el tamaño de los diseños para mejorar el rendimiento de los dispositivos. El uso de MOSFET de trinchera simple y doble permite alcanzar mayores densidades de dispositivos (Figura 2).
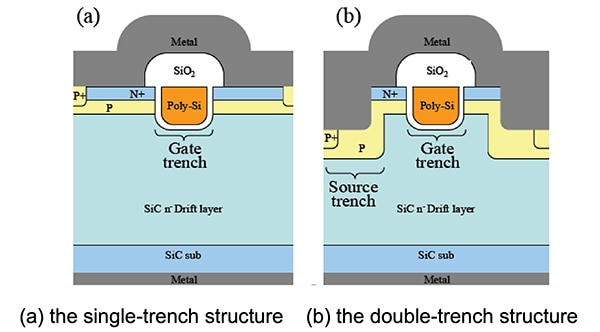 Figura 2: Los MOSFET de trinchera consiguen mayores densidades de dispositivos disponiendo los elementos del dispositivo verticalmente. (Fuente de la imagen: ROHM Semiconductor).
Figura 2: Los MOSFET de trinchera consiguen mayores densidades de dispositivos disponiendo los elementos del dispositivo verticalmente. (Fuente de la imagen: ROHM Semiconductor).
Al igual que otros MOSFET, una célula MOSFET de trinchera contiene el drenaje, la puerta y la fuente, pero está dispuesta verticalmente. El canal se forma verticalmente, paralelo a la trinchera de la compuerta, mediante el efecto de campo. La dirección del flujo de corriente es vertical de la fuente al drenaje. En comparación con un dispositivo plano, que se extiende horizontalmente y ocupa una gran superficie, esta estructura es muy compacta.
La estructura de una sola trinchera utiliza una trinchera de una sola compuerta. El dispositivo de doble trinchera tiene una puerta y una trinchera fuente. ROHM Semiconductor cambió a la estructura de doble trinchera para sus MOSFET de SiC de 3ª generación. El diseño de 4ª generación perfeccionó el diseño de doble trinchera reduciendo el tamaño de la célula, disminuyendo aún más la resistencia en estado encendido y la capacitancia parásita, lo que se traduce en pérdidas de potencia mucho menores y ofrece la posibilidad de utilizar dispositivos de SiC más pequeños para diseños de sistemas más rentables.
Disminuir la resistencia de estado activado de un MOSFET puede comprometer su capacidad para manejar cortocircuitos. Sin embargo, el MOSFET de SiC de 4ª generación consigue una menor resistencia en estado encendido sin sacrificar el tiempo de resistencia al cortocircuito, lo que proporciona a estos dispositivos una ventaja significativa a la hora de conseguir tanto una alta eficiencia como una robustez al cortocircuito.
Comprender las pérdidas
Las pérdidas en un convertidor conmutado proceden de varias fuentes; las asociadas a los dispositivos activos incluyen pérdidas de conducción, de conmutación y en el cuerpo de los diodos (Figura 3).
 Figura 3: Esquema de un convertidor reductor de CC/CC etiquetado para mostrar las formas de onda de conmutación y las formas de onda de pérdida asociadas. (Fuente de la imagen: ROHM Semiconductor)
Figura 3: Esquema de un convertidor reductor de CC/CC etiquetado para mostrar las formas de onda de conmutación y las formas de onda de pérdida asociadas. (Fuente de la imagen: ROHM Semiconductor)
El convertidor reductor utiliza un diseño de tótem con un interruptor MOSFET de lado alto (SH) y otro de lado bajo (SL). Los interruptores están desfasados, de modo que solo uno conduce a la vez. Las formas de onda de accionamiento de la puerta (VGSH y VGSL) muestran los pasos de amplitud debidos a los intervalos de carga asociados para las capacitancias parásitas del dispositivo. Se muestran las formas de onda de tensión de drenaje a fuente (VDSH, VDSL) y corriente de drenaje (IDH,IDL) de ambos dispositivos. Cuando el dispositivo está encendido, el VDS está bajo. Cuando el dispositivo está apagado, el VDS es alto. Durante el tiempo en que elSH está encendido, la corriente de drenaje aumenta linealmente mientras carga el campo magnético del inductor. Durante este tiempo, la corriente a través de la resistencia del canal desarrolla un voltaje a través del canal, dando lugar a pérdidas de conducción (PCOND) que son proporcionales al cuadrado de la corriente y la resistencia del canal. Durante los intervalos en los que el dispositivo cambia de estado, la tensión y la corriente son distintas de cero, y la potencia se disipa en el dispositivo de forma proporcional a la tensión, la corriente, el tiempo de transición de conmutación y la frecuencia de conmutación. Son las pérdidas de conmutación.
Una situación similar ocurre cuando SL está activado. Aquí, la corriente disminuye linealmente a medida que la energía almacenada en el inductor proporciona la corriente de drenaje en el dispositivo inferior. De nuevo, la resistencia del canal disipa potencia como pérdida de conducción. Observe que el VDSL en el dispositivo inferior está cerca de cero antes de que la corriente se vuelva distinta de cero, por lo que no hay pérdidas de conmutación asociadas con esta parte del ciclo.
La pérdida de recuperación (PQrr) se debe a la recuperación del diodo del cuerpo de los dispositivos; para simplificar, solo se muestra para el lado de alta.
Pbody es la conducción por diodos del cuerpo de los dispositivos. Esta pérdida se genera por la corriente conducida a través del diodo del cuerpo del dispositivo del lado bajo.
La pérdida de potencia total es la suma de todos estos componentes para ambos transistores.
Mejora del rendimiento de los MOSFET de SiC de 4ª generación
Para comparar el rendimiento de los transistores bipolares de puerta aislada (IGBT) de Si y de los MOSFET de SiC de 3ª y 4ª generación se utilizó un inversor de puente completo de 5 Kilovatios (kW) (Figura 4). En este circuito de puente completo, los dispositivos de conmutación se conectan en paralelo para aumentar la capacidad de corriente. El puente completo utiliza un total de ocho dispositivos. Los ocho dispositivos se muestran montados en el disipador de la imagen de la izquierda. La eficiencia del circuito se evaluó utilizando el IGBT original y los MOSFET de 3ª y 4ª generación. El inversor funciona a una frecuencia de conmutación de 40 Kilohertz (kHz) con los MOSFET de SiC y de 20 kHz con los IGBT.
 Figura 4: Se muestra un inversor sin ventilador de 5 kW y su esquema. Diseñado originalmente con transistores bipolares de puerta aislada (IGBT) de silicio que funcionaban a 20 kHz, este circuito se hizo funcionar con MOSFET de SiC de3ª y 4ª generación a 40 kHz. Se comparó el rendimiento de los tres tipos de semiconductores. (Fuente de la imagen: ROHM Semiconductor)
Figura 4: Se muestra un inversor sin ventilador de 5 kW y su esquema. Diseñado originalmente con transistores bipolares de puerta aislada (IGBT) de silicio que funcionaban a 20 kHz, este circuito se hizo funcionar con MOSFET de SiC de3ª y 4ª generación a 40 kHz. Se comparó el rendimiento de los tres tipos de semiconductores. (Fuente de la imagen: ROHM Semiconductor)
El dispositivo de 3ª generación era un dispositivo SCT3030AL de ROHM Semiconductor con una tensión nominal de 650 voltios y una resistencia de canal (RDS(ON)) de 30 miliohmios (mΩ). El MOSFET de 4ª generación era un SCT4026DEC11 de ROHM Semiconductor. El voltaje nominal del dispositivo de 4ª generación se aumentó a 750 voltios. Su RDS(ON) es de 26 mΩ, una reducción del 13% que disminuyó ligeramente las pérdidas por conducción.
La comparación de las pérdidas de ambos MOSFET de SiC con las del IGBT original muestra la mejora de la eficiencia (Figura 5).
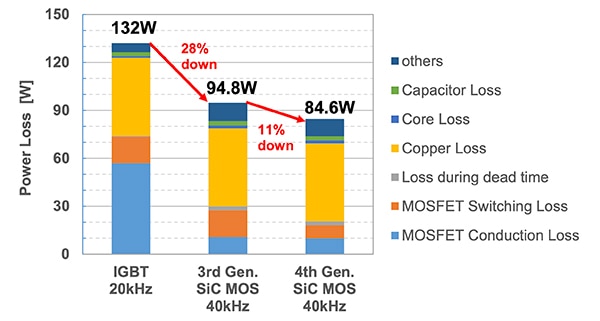 Figura 5: Los MOSFET de SiC de 4ª generación redujeron significativamente las pérdidas en comparación con el IGBT de Si original y el dispositivo de 3ª generación. (Fuente de la imagen: ROHM Semiconductor).
Figura 5: Los MOSFET de SiC de 4ª generación redujeron significativamente las pérdidas en comparación con el IGBT de Si original y el dispositivo de 3ª generación. (Fuente de la imagen: ROHM Semiconductor).
El dispositivo de 4ª generación redujo las pérdidas por conducción (azul) de 10.7 a 9.82 vatios en comparación con el de 3ª generación. Una reducción más significativa se logró con las pérdidas por conmutación (naranja), una disminución de 16.6 a 8.22 vatios.
Entre las mejoras adicionales de los dispositivos de 4ª generación se incluye la capacidad mejorada de accionamiento de compuertas. Los MOSFET de SiC de 4ª generación admiten una alimentación de 15 voltios; los dispositivos de 3ª generación requieren 18 voltios. Esto significa que los circuitos diseñados con dispositivos Si pueden utilizar MOSFET de 4ª generación como sustitutos directos. Además, la tensión de accionamiento recomendada durante el apagado es de 0 voltios para los MOSFET de SiC de 4ª generación. Antes de los productos de 4ª generación, la tensión de la puerta a la fuente necesitaba una polarización negativa durante el apagado para evitar el autoencendido. Sin embargo, en los dispositivos de 4ª generación, la tensión de umbral (Vth) está diseñada para ser alta con el fin de suprimir el autoencendido, eliminando la necesidad de aplicar polarización negativa.
Soluciones de 4ª generación
Las soluciones MOSFET SiC de 4ª generación de ROHM Semiconductor se dividen en dos grupos en función del encapsulado del dispositivo. El SCT4026DEC11, del que ya se habló, es un MOSFET de SiC de 750 voltios, 56 amperios (A) (+25°C)/29 A (+100°C) y 26 mΩ en un encapsulado TO-247N de tres terminales. Un ejemplo de encapsulado alternativo de cuatro terminales es el SCT4013DRC15, un dispositivo de 750 voltios, 105 A (+25°C)/74 A (+100°C), 13 mΩ en un encapsulado TO-247-4L de cuatro terminales.
El encapsulado de cuatro terminales añade un terminal adicional que mejora la velocidad de conmutación del MOSFET. El encapsulado convencional TO-247N de tres patillas no aísla el accionamiento de la puerta de la inductancia parásita fuente-terminal debido a la alta corriente de drenaje. El voltaje de puerta se aplica entre los pines de puerta y fuente. La tensión de puerta efectiva en el chip se reduce debido a la caída de voltaje a través de la inductancia parásita (VL) del terminal de fuente, lo que provoca una reducción de la velocidad de conmutación (Figura 6).
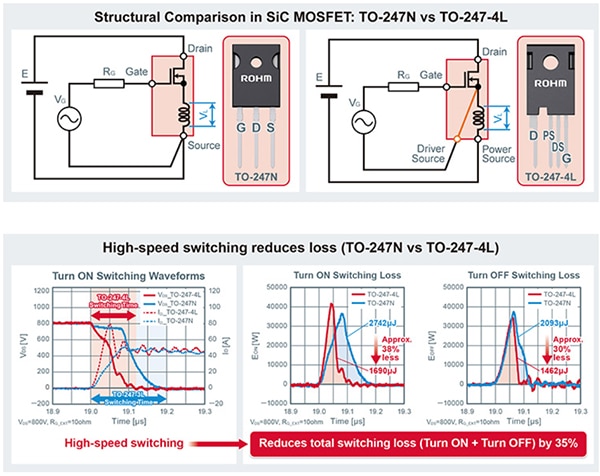 Figura 6: La cuarta patilla del TO-247-4L aísla el accionamiento de la puerta de las patillas de la fuente de alimentación mediante una patilla de conexión adicional en una conexión Kelvin. (Fuente de la imagen: ROHM Semiconductor)
Figura 6: La cuarta patilla del TO-247-4L aísla el accionamiento de la puerta de las patillas de la fuente de alimentación mediante una patilla de conexión adicional en una conexión Kelvin. (Fuente de la imagen: ROHM Semiconductor)
El encapsulado TO-247-4L de cuatro patillas divide los pines de accionamiento de la puerta y de la fuente de alimentación, conectando internamente el accionamiento de la puerta directamente a la fuente. Esto minimiza los efectos de la inductancia parásita del pin fuente. La conexión directa del accionamiento de la puerta a la conexión de la fuente interna permite maximizar la velocidad de conmutación de los MOSFET de SiC, reduciendo la pérdida total de conmutación (encendido y apagado) hasta un 35% en comparación con los encapsulados TO-247N convencionales de tres patillas.
La segunda especificación diferenciadora de los MOSFET de SiC de4ª generación es el voltaje nominal. Los dispositivos están disponibles con voltajes nominales de 750 voltios o 1200 voltios. Los dos dispositivos analizados hasta ahora tienen voltajes nominales de 750 voltios. Para aplicaciones de mayor voltaje, el SCT4062KEC11 es un MOSFET de canal N de SiC de 1200 voltios, 62 mΩ, 26 A (+25 °C)/18 A (+100 °C) en un encapsulado TO-247N de tres terminales, mientras que el SCT4036KRC15 es un MOSFET de canal N de 1200 voltios, 36 mΩ, 43 A (+25 °C)/30 A (+100 °C) en un encapsulado TO-247-4L de cuatro terminales. En total, actualmente hay diez MOSFET de SiC de 4ª generación disponibles, con valores de corriente de 26 A a 105 A a +25 °C. Tienen valores RDS(ON ) que oscilan entre 13 y 62 mΩ.
Aplicaciones EV
Las especificaciones de los MOSFET de SiC de 4ª generación se adaptan perfectamente a las aplicaciones de los vehículos eléctricos. Los VE con batería (BEV) con voltajes de 400 u 800 voltios son un ejemplo (Figura 7).
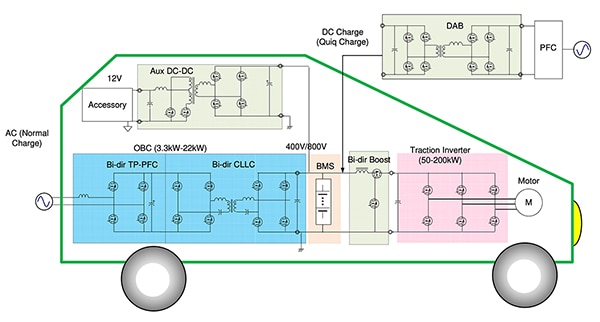 Figura 7: Aplicaciones típicas de MOSFET de SiC de 4ª generación en un BEV y accesorios externos asociados. (Fuente de la imagen: ROHM Semiconductor)
Figura 7: Aplicaciones típicas de MOSFET de SiC de 4ª generación en un BEV y accesorios externos asociados. (Fuente de la imagen: ROHM Semiconductor)
La figura 7 muestra un diagrama de bloques de un BEV con un voltaje de batería de 400 u 800 voltios, compatible con la carga rápida y bidireccional. El cargador de a bordo (OBC) incluye circuitos de corrección del factor de potencia (PFC) de tipo tótem y un convertidor resonante CLLC (condensador, inductor, inductancia, condensador) bidireccional de puente completo. El cargador externo de CC de carga 'Quiq' proporciona carga directa a la batería. La batería acciona el inversor de tracción, que convierte la CC en CA trifásica para accionar el motor. Todos estos circuitos emplean MOSFET en diversas configuraciones de circuito para manejar los niveles de potencia requeridos. Los MOSFET de SiC de 4ª generación son importantes porque reducen el tamaño físico del circuito y aumentan el voltaje nominal, al tiempo que reducen las pérdidas y los costos.
Conclusión:
Para los diseñadores de aplicaciones de alta tensión y alta potencia, como vehículos eléctricos, centros de datos y estaciones base, los MOSFET de SiC de 4ª generación son dispositivos de conmutación de potencia clave. Como se muestra, utilizan una estructura única para mejorar enormemente la eficiencia de la conversión de potencia mediante la reducción de las pérdidas, al tiempo que reducen la huella y el coste.
Lectura recomendada:

Descargo de responsabilidad: Las opiniones, creencias y puntos de vista expresados por los autores o participantes del foro de este sitio web no reflejan necesariamente las opiniones, las creencias y los puntos de vista de DigiKey o de las políticas oficiales de DigiKey.







