Por qué y cómo aplicar los transistores de efecto de campo de GaN a aplicaciones de potencia eficientes, de alto voltaje y en modo conmutado
Colaboración de Editores de DigiKey de América del Norte
2023-01-26
La eficiencia energética es una prioridad de los sistemas electrónicos ante las exigencias sociales y normativas. En particular, para aplicaciones que van desde los vehículos eléctricos (VE) hasta las comunicaciones de alta tensión y la infraestructura industrial, la eficiencia de la conversión de potencia y la densidad de potencia son fundamentales para el éxito del diseño.
Para cumplir estos requisitos, los diseñadores de sistemas de potencia conmutados tienen que dejar de utilizar los clásicos transistores de óxido de metal de efecto de campo (MOSFET) y transistores bipolares de puerta aislada (IGBT) basados en silicio (Si), ya que se están acercando rápidamente a sus límites teóricos.
En su lugar, los diseñadores deben considerar dispositivos basados en materiales de banda prohibida (WBG) como el nitruro de galio (GaN). Los dispositivos de GaN conmutan más rápido que los de Si, soportan mayores niveles de voltaje y potencia, son mucho más pequeños para un nivel de potencia dado y funcionan con una eficiencia mucho mayor.
En este artículo se examinan los fundamentos de los FET de GaN, se muestran sus ventajas frente a los dispositivos tradicionales de Si en los circuitos de potencia en modo interruptor, se presentan ejemplos reales de Nexperia y se analizan sus aplicaciones.
Los fundamentos de los transistores de efecto de campo (FET) de GaN
Los elementos fundamentales de los circuitos de conversión de potencia son los interruptores semiconductores de alta tensión. Los diseñadores se han centrado en mejorar el rendimiento de estos dispositivos: disminuyendo las pérdidas de conducción al reducir la resistencia en serie en estado, disminuyendo las pérdidas de conmutación al aumentar las velocidades de transición y reduciendo los efectos parásitos. Estos esfuerzos de diseño han tenido éxito, en general, en los MOSFET e IGBT de silicio, pero el ritmo de mejora se ha ido ralentizando a medida que el funcionamiento de estos dispositivos alcanzaba sus límites teóricos.
Como resultado, en los últimos años se han introducido dispositivos WBG que utilizan carburo de silicio (SiC) y GaN, hasta el punto de que han alcanzado la producción en serie. Estos dispositivos ofrecen rangos de tensión de funcionamiento más altos, tiempos de conmutación más rápidos y mayor eficiencia.
La banda prohibida de un semiconductor es la energía mínima necesaria para excitar a los electrones y liberarlos de su estado ligado a un estado libre para conducir la electricidad (Tabla 1).
|
Cuadro 1: Resumen de las principales propiedades que distinguen a los semiconductores de banda prohibida -como el GaN y el SiC- del Si. (Fuente de la tabla: Art Pini)
Los dispositivos fabricados con semiconductores de banda prohibida pueden funcionar a tensiones, frecuencias y temperaturas mucho más elevadas que los semiconductores convencionales, como el Si. La banda prohibida más ancha es especialmente importante para permitir que los dispositivos funcionen a temperaturas mucho más elevadas. La alta tolerancia a la temperatura significa que, en condiciones normales, estos dispositivos pueden funcionar a niveles de potencia mucho más elevados. Los semiconductores WBG con un campo eléctrico crítico más elevado y una movilidad más alta tienen la menor resistencia de drenaje-fuente en estado encendido (RDS(ON)), lo que reduce las pérdidas de conducción.
La mayoría de los materiales de banda prohibida también tienen altas velocidades de electrones libres, lo que les permite trabajar a velocidades de interruptor más altas.
En comparación con el Si, que tiene una banda prohibida de 1.12 electronvoltios (eV), el GaN y el SiC son semiconductores compuestos con bandas prohibidas unas tres veces mayores, de 3.4 eV y 3.3 eV, respectivamente. Esto significa que ambos pueden soportar voltajes y frecuencias más altos.
La mayor movilidad de electrones del GaN lo hace mucho más adecuado para aplicaciones de alto rendimiento y alta frecuencia. Las velocidades de conmutación más rápidas y las frecuencias de funcionamiento más altas que permiten los FET de potencia de GaN se traducen en un mejor control de la señal, diseños de filtros pasivos con frecuencias de corte más altas y corrientes de ondulación más bajas. Esto permite utilizar inductores, capacitores y transformadores más pequeños, lo que se traduce en una reducción del tamaño y el peso totales.
Los FET de GaN se denominan transistores de alta movilidad de electrones (HEMT). El transistor de efecto de campo (FET) tiene una elevada movilidad de electrones (Figura 1).
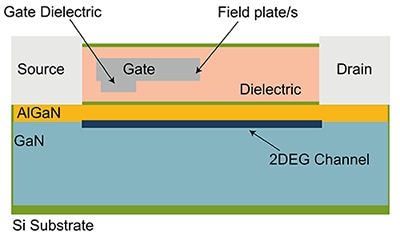 Figura 1: Vista transversal de un transistor de efecto de campo (FET) de GaN sobre un sustrato de Si. (Fuente de la imagen: Nexperia)
Figura 1: Vista transversal de un transistor de efecto de campo (FET) de GaN sobre un sustrato de Si. (Fuente de la imagen: Nexperia)
El transistor de efecto de campo (FET) de GaN utiliza las actuales instalaciones de producción de semiconductores de silicio CMOS, lo que lo hace rentable. Se forma una capa de GaN sobre el sustrato de Si depositando una capa de semilla y una capa graduada de GaN y nitruro de galio de aluminio (AlGaN) como capa de aislamiento (no se muestra en el diagrama) antes de que crezca la capa de GaN puro. Se deposita una segunda capa de AlGaN sobre la capa de GaN. Esto establece una polarización piezoeléctrica, generándose un exceso de electrones inmediatamente por debajo del AlGaN, que es un canal altamente conductor. Este exceso de electrones se conoce como gas bidimensional de electrones (2DEG). El nombre refleja la gran movilidad de los electrones en esta capa.
Bajo la puerta se forma una región de agotamiento. El funcionamiento de la puerta es similar al de un MOSFET de potencia de silicio de canal N en modo de mejora. Un voltaje positivo aplicado a la puerta de este dispositivo lo enciende.
Esta estructura se repite varias veces para formar un dispositivo de potencia. El resultado final es una solución fundamentalmente sencilla, elegante y rentable para la conmutación de potencia.
Para obtener un dispositivo de mayor voltaje, se aumenta la distancia entre el Drenaje y la Puerta. Como la resistividad del GaN 2DEG es muy baja, el impacto sobre la resistencia al aumentar la capacidad de tensión de bloqueo es mucho menor en comparación con los dispositivos de silicio.
El transistor de efecto de campo (FET) de GaN puede construirse para funcionar en cualquiera de las dos configuraciones siguientes: modo de mejora o modo de mínima. Los FET de modo de Mejora están normalmente apagados, por lo que debe aplicarse una tensión positiva relativa al drenaje/fuente a la puerta para encender el FET. Los FET de modo de agotamiento están normalmente encendidos, por lo que debe aplicarse una tensión de puerta negativa con respecto al drenaje/fuente para apagar el FET. El transistor de efecto de campo (FET) en modo de mínima es problemático en un sistema de alimentación eléctrica porque hay que aplicar una polarización negativa al FET de GaN en modo de mínima antes de encender el sistema.
Una forma de resolver este problema es combinar un FET de silicio de bajo voltaje con un FET de GaN en modo de agotamiento en una configuración de circuito en cascada (Figura 2).
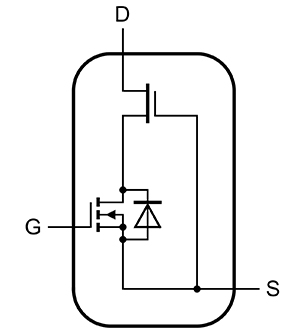 Figura 2: Un MOSFET de silicio de bajo voltaje en una configuración en cascada con un FET de GaN en modo de agotamiento da como resultado la resistencia de la estructura de puerta de Si con las características mejoradas de sincronización de alto voltaje del dispositivo de GaN, así como tener -en el caso de un FET de GaN en modo de agotamiento- el dispositivo compuesto apagado en el encendido. (Fuente de la imagen: Nexperia)
Figura 2: Un MOSFET de silicio de bajo voltaje en una configuración en cascada con un FET de GaN en modo de agotamiento da como resultado la resistencia de la estructura de puerta de Si con las características mejoradas de sincronización de alto voltaje del dispositivo de GaN, así como tener -en el caso de un FET de GaN en modo de agotamiento- el dispositivo compuesto apagado en el encendido. (Fuente de la imagen: Nexperia)
El circuito en cascada utiliza la estructura de compuerta de MOSFET Si, que presenta las ventajas de unos límites de accionamiento de compuerta más elevados, adaptados a los CI controladores de compuerta de MOSFET existentes, y de que el FET de GaN de modo de agotamiento está desactivado al encenderse.
El transistor de efecto de campo (FET) de GaN se caracteriza por su alto rendimiento. Esto se debe a: su baja resistencia en serie, que reduce las pérdidas por conducción; sus tiempos de conmutación más rápidos, que reducen las pérdidas por conmutación; y su menor carga de recuperación inversa, que explica sus bajas pérdidas por recuperación inversa.
Utilizando una topología común de convertidor elevador de medio puente, es posible comparar las eficiencias de los FET de GaN y los MOSFET de Si (Figura 3).
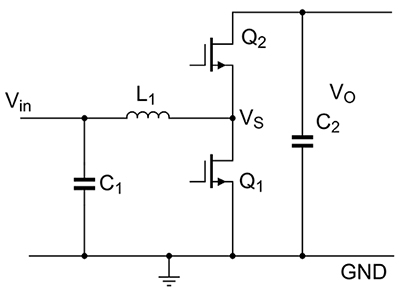 Figura 3: Se muestra el esquema de un convertidor elevador de medio puente utilizado para comparar las eficiencias de los MOSFET y los FET de GaN intercambiando los transistores Q1 y Q2 con cada tipo. (Fuente de la imagen: Nexperia)
Figura 3: Se muestra el esquema de un convertidor elevador de medio puente utilizado para comparar las eficiencias de los MOSFET y los FET de GaN intercambiando los transistores Q1 y Q2 con cada tipo. (Fuente de la imagen: Nexperia)
El convertidor elevador tiene una tensión de entrada de 240 voltios, la salida es de 400 voltios y la frecuencia de conmutación es de 100 kilohercios (kHz). Las eficiencias y pérdidas se comparan en un rango de potencias de hasta 3500 vatios (Figura 4).
 Figura 4: Comparación de la eficiencia y la pérdida de potencia entre los FET de GaN y los MOSFET en un circuito idéntico, lo que demuestra las ventajas de los FET de GaN. (Fuente de la imagen: Nexperia)
Figura 4: Comparación de la eficiencia y la pérdida de potencia entre los FET de GaN y los MOSFET en un circuito idéntico, lo que demuestra las ventajas de los FET de GaN. (Fuente de la imagen: Nexperia)
El rendimiento de los FET de GaN es un 20% superior al de los MOSFET, y la pérdida de potencia es tres veces menor. A 2000 vatios, la pérdida en los MOSFET es de unos 62 vatios; en los FET de GaN es de solo 19 vatios. Esto significa que el sistema de refrigeración puede ser más pequeño, mejorando así la eficiencia volumétrica del convertidor elevador.
Menos obvio es que la medición se llevó a cabo hasta casi 3500 vatios para el FET de GaN debido a su mayor límite de voltaje máximo. El transistor de efecto de campo (FET) de GaN tiene una clara ventaja.
Primeros pasos con GaN para voltajes más altos
Para aplicaciones de mayor voltaje, Nexperia ofrece dos FET de GaN de 650 voltios, el GAN063-650WSAQ y el GAN041-650WSBQ. Ambos son FET de canal N que normalmente están apagados. El GAN063-650WSAQ está preparado para manejar una tensión máxima de drenaje a fuente de 650 voltios y puede soportar un transitorio (con un ancho de pulso inferior a un microsegundo) de 800 voltios. Está preparado para una corriente de drenaje de 34.5 amperios (A) y una disipación de potencia de 143 Vatios a 25 °C. La resistencia en estado encendido de drenaje a fuente suele ser de 50 miliohmios (mΩ), con un límite máximo de 60 mΩ.
El GAN041-650WSBQ tiene el mismo voltaje nominal máximo de drenaje a fuente de 650 voltios con el mismo límite transitorio de 800 voltios. Se diferencia en que puede manejar una corriente de drenaje máxima de 47.2 A y una disipación de potencia máxima de 187 vatios a temperatura ambiente. Su resistencia de canal típica es de 35 mΩ, con un máximo de 41 mΩ.
En la Figura 5 se muestra un diseño de referencia de Nexperia que utiliza el GAN063-650WSAQ en una configuración de medio puente.
 Figura 5: Diseño recomendado de una etapa de potencia de medio puente con FET de GaN GAN063-650WSA. El esquema solo muestra el controlador de efecto de campo (FET) y la etapa de salida de medio puente, así como los componentes relacionados. (Fuente de la imagen: Nexperia)
Figura 5: Diseño recomendado de una etapa de potencia de medio puente con FET de GaN GAN063-650WSA. El esquema solo muestra el controlador de efecto de campo (FET) y la etapa de salida de medio puente, así como los componentes relacionados. (Fuente de la imagen: Nexperia)
El esquema muestra el controlador de compuerta aislado dual alto/bajo Si8230, que se utiliza para accionar las compuertas de los FET de GaN. La salida del controlador de compuerta se conecta a la compuerta a través de una resistencia/resistor de compuerta de 30 Ω, necesaria para todos los dispositivos GaN. La resistencia/resistor de puerta controla el tiempo de carga de la capacitancia de puerta, lo que afecta al rendimiento de conmutación dinámica. Las redes R-C entre el drenaje y la fuente de los transistores de efecto de campo (FET) también ayudan a controlar el rendimiento de la conmutación. El transistor de efecto de campo (FET) de GaN puede funcionar a una tensión de entre 0 y 10-12 voltios.
La alta velocidad de conmutación de los FET de GaN (normalmente en el rango de 10 a 11 nanosegundos (ns)) requiere un diseño cuidadoso para minimizar la inductancia parásita y el uso de amortiguadores RC para amortiguar el zumbido debido a los transitorios de voltaje y corriente. Hay múltiples amortiguadores RC (R17 a 19 y C33 a 35) en el diseño entre la alimentación de alto voltaje y tierra. Los amortiguadores reducen el zumbido causado por la interacción del FET de GaN y la red de derivación. Los amortiguadores deben conectarse lo más cerca posible del drenaje del FET de lado alto. Se implementan con resistencias/resistores de montaje en superficie y condensadores cerámicos de baja resistencia equivalente en serie (ESR) para minimizar la inductancia del terminal.
La red de componentes formada por R4, D1, C12 y C13 es una fuente de alimentación de arranque para el controlador de compuerta de lado alto. D1 debe ser un diodo rápido de baja capacitancia porque su capacitancia de unión contribuye a la pérdida de conmutación. R4 limita la corriente de irrupción de carga; un valor en el rango de 10 a 15 Ω funciona bien.
Conclusión:
Desde los vehículos eléctricos hasta las comunicaciones y la infraestructura industrial, la necesidad de una mayor eficiencia de conversión de potencia y densidad de potencia exige un cambio de las estructuras clásicas de Si. Como se ha demostrado, los transistores de efecto de campo (FET) de GaN suponen un avance para los diseños de nueva generación, ya que ofrecen tensiones de funcionamiento más altas, tiempos de conmutación más rápidos y mayor eficiencia. Los componentes estándar, respaldados en algunos casos por diseños de referencia, ayudan a los diseñadores a poner en marcha sus proyectos con rapidez.

Descargo de responsabilidad: Las opiniones, creencias y puntos de vista expresados por los autores o participantes del foro de este sitio web no reflejan necesariamente las opiniones, las creencias y los puntos de vista de DigiKey o de las políticas oficiales de DigiKey.